Plazmové leptání - Plasma etching
tento článek potřebuje další citace pro ověření. (Prosinec 2008) (Zjistěte, jak a kdy odstranit tuto zprávu šablony) |
Plazmové leptání je forma zpracování plazmy používá se k výrobě integrované obvody. Zahrnuje vysokorychlostní proud výboje (plazma ) vhodné směsi plynu stříkané (v pulzech) na vzorek. Zdroj plazmy, známý jako druhy leptů, lze buď nabít (ionty ) nebo neutrální (atomy a radikály ). Během procesu plazma generuje těkavé produkty leptání při pokojové teplotě z chemické reakce mezi prvky leptaného materiálu a reaktivními látkami generovanými plazmou. Atomy zastřeleného prvku se nakonec vrhly na nebo těsně pod povrch cíle, čímž modifikovaly fyzikální vlastnosti cíle.[1]
Mechanismy
Generování plazmy
Plazma je vysoce energetický stav, ve kterém může nastat mnoho procesů. Tyto procesy probíhají kvůli elektronům a atomům. K vytvoření plazmové elektrony musí být urychleny, aby získaly energii. Vysoce energetické elektrony přenášejí energii na atomy srážkami. Kvůli těmto kolizím mohou nastat tři různé procesy:[2][3]
V plazmě jsou přítomny různé druhy, jako jsou elektrony, ionty, radikály a neutrální částice. Tyto druhy mezi sebou neustále interagují. Plazmové leptání lze rozdělit do dvou hlavních typů interakce:[4]
- generace chemických druhů
- interakce s okolními povrchy
Bez plazmy by všechny tyto procesy probíhaly při vyšší teplotě. Existují různé způsoby, jak změnit chemii plazmy a získat různé druhy leptání plazmy nebo depozice plazmy. Jednou z excitačních technik pro vytvoření plazmy je použití RF excitace zdroje energie 13,56 MHz.
Režim provozu plazmového systému se změní, pokud se změní provozní tlak. Rovněž se liší pro různé struktury reakční komory. V jednoduchém případě je struktura elektrody symetrická a vzorek je umístěn na uzemněnou elektrodu.
Vlivy na proces
Klíčem k vývoji úspěšných složitých procesů leptání je nalezení vhodné chemie leptání plynem, která vytvoří těkavé produkty s leptaným materiálem, jak je uvedeno v tabulce 1.[3] U některých obtížných materiálů (například magnetických materiálů) lze těkavost dosáhnout pouze tehdy, když se zvýší teplota destičky. Hlavní faktory, které ovlivňují proces plazmy:[2][3][5]
- Zdroj elektronů
- Tlak
- Druhy plynů
- Vakuum
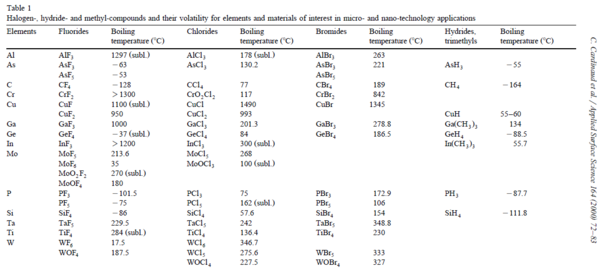
Povrchová interakce
Reakce produktů závisí na pravděpodobnosti reakce odlišných atomů, fotonů nebo radikálů za vzniku chemických sloučenin. Teplota povrchu také ovlivňuje reakci produktů. Adsorpce nastává, když je látka schopna shromáždit se a dostat se na povrch v kondenzované vrstvě, jejíž tloušťka (obvykle tenká, oxidovaná vrstva.) Těkavé produkty desorbují v plazmové fázi a pomáhají procesu leptání plazmy, když materiál interaguje s vzorkem stěny. Pokud produkty nejsou těkavé, vytvoří se na povrchu materiálu tenký film. Různé principy, které ovlivňují schopnost vzorku pro leptání plazmou:[3][6]
- Volatilita
- Adsorpce
- Chemická afinita
- Iontové bombardování
- Prskání
Plazmové leptání může změnit kontaktní kontaktní úhly povrchu, například hydrofilní na hydrofobní nebo naopak. Leptání argonovou plazmou uvádí, že zvyšuje kontaktní úhel z 52 stupňů na 68 stupňů,[7] a leptání kyslíkovou plazmou ke snížení kontaktního úhlu z 52 stupňů na 19 stupňů pro kompozity CFRP pro aplikace na kostní dlahu. Bylo popsáno, že plazmové leptání snižuje drsnost povrchu ze stovek nanometrů až na 3 nm u kovů.[8]
Typy
Tlak ovlivňuje proces leptání plazmou. Aby mohlo dojít k leptání plazmou, musí být komora pod nízkým tlakem, menším než 100 Pa. Aby se vytvořila nízkotlaká plazma, musí být plyn ionizován. K ionizaci dochází pomocí záře. K těmto excitacím dochází prostřednictvím externího zdroje, který může dodávat až 30 kW a frekvence od 50 Hz (ss.) Do 5–10 Hz (pulsní ss.) Na rádiovou a mikrovlnnou frekvenci (MHz-GHz).[2][9]
Mikrovlné plazmové leptání
K mikrovlnnému leptání dochází u zdrojů buzení na mikrovlnné frekvenci, tedy mezi MHz a GHz. Zde je uveden jeden příklad leptání plazmou.[10]

Vodíkové plazmové leptání
Jednou formou použití plynu jako leptání plazmy je leptání vodíkovou plazmou. Proto lze použít experimentální zařízení, jako je toto:[5]

Aplikace
Plazmové leptání se v současné době používá ke zpracování polovodičových materiálů pro jejich použití při výrobě elektroniky. Drobné prvky lze do povrchu polovodičového materiálu leptat, aby byly efektivnější nebo vylepšily určité vlastnosti při použití v elektronických zařízeních.[3] Například plazmové leptání lze použít k vytvoření hlubokých zákopů na povrchu křemíku pro použití v mikroelektromechanické systémy. Tato aplikace naznačuje, že leptání plazmou má také potenciál hrát hlavní roli ve výrobě mikroelektroniky.[3] Podobně se v současné době provádí výzkum, jak lze tento proces přizpůsobit měřítku nanometrů.[3]
Zejména leptání vodíkovou plazmou má další zajímavé aplikace. Při použití v procesu leptání polovodičů se ukázalo, že leptání vodíkovou plazmou je účinné při odstraňování částí nativních oxidů nacházejících se na povrchu.[5] Vodíkové plazmové leptání má také tendenci zanechávat čistý a chemicky vyvážený povrch, který je ideální pro řadu aplikací.[5]
Leptání kyslíkovou plazmou lze použít k anizotropnímu hlubokému leptání diamantových nanostruktur aplikací vysokého zkreslení v reaktoru s indukčně vázaným plazmatem / leptáním reaktivními ionty (ICP / RIE)[11]. Na druhé straně může být pro izotropní povrchové zakončení C-H zakončeného diamantového povrchu použito použití kyslíkových předpjatých plazmat.[12]
Viz také
Reference
- ^ "Plazmový lept - Plazmový lept". oxinst.com. Citováno 2010-02-04.
- ^ A b C Mattox, Donald M. (1998). Příručka zpracování fyzikální depozice par (PVD). Westwood, New Jersey: publikace Noyes.
- ^ A b C d E F G Cardinaud, Christophe; Peignon, Marie-Claude; Tessier, Pierre-Yves (01.09.2000). „Plazmové leptání: principy, mechanismy, aplikace na mikro- a nano-technologie“. Aplikovaná věda o povrchu. Surface Science in Micro & Nanotechnology. 164 (1–4): 72–83. Bibcode:2000ApSS..164 ... 72C. doi:10.1016 / S0169-4332 (00) 00328-7.
- ^ Coburn, J. W .; Winters, Harold F. (01.03.1979). „Plazmové leptání - diskuse o mechanismech“. Journal of Vacuum Science & Technology. 16 (2): 391–403. Bibcode:1979JVST ... 16..391C. doi:10.1116/1.569958. ISSN 0022-5355.
- ^ A b C d Chang, R. P. H .; Chang, C. C .; Darac, S. (01.01.1982). "Vodíkové plazmové leptání polovodičů a jejich oxidů". Journal of Vacuum Science & Technology. 20 (1): 45–50. Bibcode:1982JVST ... 20 ... 45C. doi:10.1116/1.571307. ISSN 0022-5355.
- ^ Coburn, J. W .; Winters, Harold F. (01.05.1979). „Chemie povrchu plynu s pomocí iontů a elektronů - důležitý účinek při leptání plazmou“. Journal of Applied Physics. 50 (5): 3189–3196. Bibcode:1979JAP .... 50.3189C. doi:10.1063/1.326355. ISSN 0021-8979. S2CID 98770515.
- ^ Zia, A. W .; Wang, Y. -Q .; Lee, S. (2015). „Vliv fyzikálního a chemického leptání plazmou na smáčivost povrchu polymerních kompozitů vyztužených uhlíkovými vlákny pro aplikace na kostní desky“. Pokroky v polymerní technologii. 34: n / a. doi:10.1002 / adv.21480.
- ^ Wasy, A .; Balakrishnan, G .; Lee, S. H .; Kim, J. K .; Kim, D. G .; Kim, T. G .; Song, J. I. (2014). „Zpracování argonovou plazmou na kovových podkladech a účinky na vlastnosti povlaku podobného diamantu jako uhlíku (DLC)“. Crystal Research and Technology. 49: 55–62. doi:10.1002 / crat.201300171.
- ^ Bunshah, Rointan F. (2001). Deposition Technologies for Films and Coatings. New York: Noyes Publication.
- ^ Keizo Suzuki; Sadayuki Okudaira; Norriyuki Sakudo; Ichiro Kanomata (11. listopadu 1977). "Leptání v mikrovlnné plazmě". Japonský žurnál aplikované fyziky. 16 (11): 1979–1984. Bibcode:1977JaJAP..16.1979S. doi:10.1143 / jjap.16.1979.
- ^ Radtke, Mariusz; Nelz, Richard; Slablab, Abdallah; Neu, Elke (2019). „Spolehlivá nanofabrikace jednokrystalických diamantových fotonických nanostruktur pro snímání v nanoměřítku“. Mikromotory. 10 (11): 718. arXiv:1909.12011. Bibcode:2019arXiv190912011R. doi:10,3390 / mi10110718. PMID 31653033. S2CID 202889135.
- ^ Radtke, Mariusz; Render, Lara; Nelz, Richard; Neu, Elke (2019). "Plazmové úpravy a fotonické nanostruktury pro mělká centra uvolňování dusíku v diamantu". Optické materiály Express. 9 (12): 4716. arXiv:1909.13496. Bibcode:2019arXiv190913496R. doi:10.1364 / OME.9.004716. S2CID 203593249.
